Exclusiva caracterización de defectos basada en topografía de rayos X para obleas de SiC galardonada con el premio a la innovación Georg Waeber 2023
Anuncios
Un equipo interinstitucional de Rigaku SE y Fraunhofer IISB ha establecido un nuevo método de caracterización de materiales semiconductores en el Centro de Experiencia en Topografía de Rayos X que gestionan conjuntamente en Erlangen, Alemania. No sólo han conseguido desarrollar un sistema de topografía por rayos X listo para la industria, sino también emplear algoritmos de detección y cuantificación de defectos, logrando un método de caracterización de materiales único en el mundo para obleas de carburo de silicio (SiC). El SiC es un semiconductor excelente para áreas de aplicación como la movilidad y el transporte eléctricos, el suministro de energía sostenible, la infraestructura industrial hasta los sensores y las tecnologías cuánticas, incluso en condiciones de funcionamiento duras. Como representantes de todo el equipo de investigación, el Dr. Kranert y el Dr. Reimann del Fraunhofer IISB y el Dr. Hippler, Director General de Rigaku Europe SE, han ganado el Premio a la Innovación Georg Waeber 2023 de la Förderkreis für die Mikroelektronik e.V. (Sociedad de Promoción de la Microelectrónica).
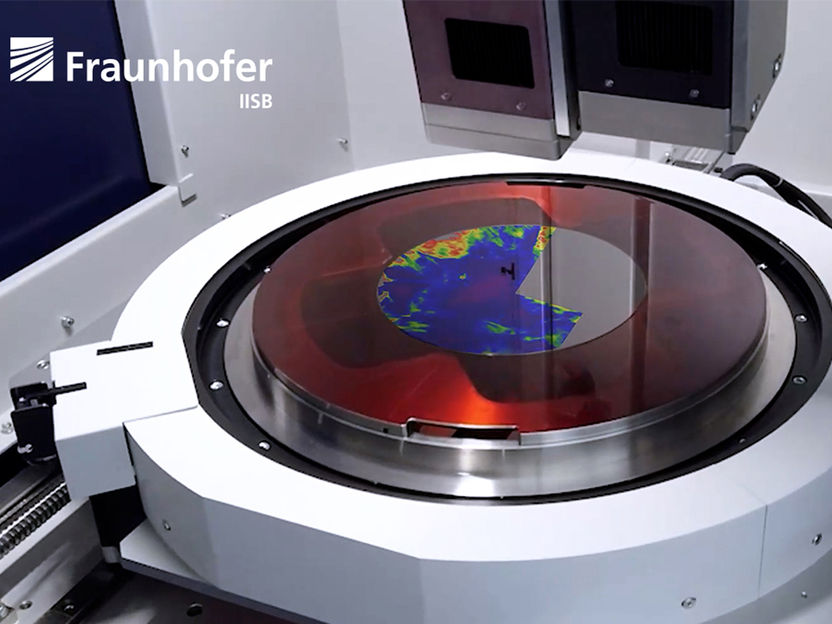
Vista en la herramienta del Rigaku XRTmicron con mapa de defectos animado para mostrar el proceso de metrología no destructiva y de alta velocidad en toda la superficie de la oblea.
© Elisabeth Iglhaut / Fraunhofer IISB
Pioneros en la caracterización holística de defectos de materiales con topografía de rayos X
En 2021, Rigaku SE y Fraunhofer IISB han fundado el Centro de Experiencia para Topografía de Rayos X, un laboratorio conjunto que se encuentra en la sede del IISB en Erlangen, Alemania. Aquí, el equipo interinstitucional ha desarrollado una nueva metrología no destructiva, robusta, fiable, de alto rendimiento y, por tanto, capaz de detectar rápidamente todos los defectos cristalográficos relevantes en sustratos de SiC. Por primera vez en el mundo, esta innovación se ha llevado a cabo mediante un enfoque holístico que incluye la configuración del dispositivo de medición, es decir, la herramienta de topografía de rayos X (XRT), así como la formulación de rutinas de medición y análisis adecuadas que satisfagan específicamente las demandas de la industria en cuanto a velocidad, fiabilidad y precisión. El proceso de desarrollo se apoyó en una rigurosa validación científica de los resultados, un factor crucial para la aceptación de un nuevo enfoque en la industria.
Hasta ahora, no existía una metrología preparada para la industria en las primeras fases de la fabricación de electrónica de potencia de SiC, especialmente a nivel de sustrato o cristal (comúnmente denominado "disco"). Este avance en la inspección de sustratos de SiC hace que ya no sea necesario, por ejemplo, grabar destructivamente los defectos y desechar los sustratos semiconductores para su caracterización, como suele ocurrir en la actualidad. En consecuencia, la metrología XRT desarrollada es superior a estos métodos de caracterización de sustratos empleados actualmente en la industria, lo que en última instancia supone un importante ahorro de costes.
Efectivamente, esta tecnología, desarrollada en Alemania, proporciona todo lo necesario para convertirse en el estándar de la industria para especificar y controlar la calidad de los sustratos en la producción, así como para los fabricantes de sustratos y dispositivos de I+D de todo el mundo. El éxito de esta innovación conjunta queda patente en el nuevo negocio que Rigaku ha logrado establecer en menos de dos años. Ahora, la empresa con sede en Japón es el principal proveedor mundial de herramientas XRT para la fabricación de sustratos y dispositivos de SiC.
El innovador enfoque metrológico ha sido impulsado de forma significativa por el Dr. Michael Hippler, Director General de Rigaku Europe SE, y el Dr. Christian Kranert junto con el Dr. Christian Reimann, ambos directores de grupo del departamento de Materiales del Fraunhofer IISB. De ahí que los científicos hayan sido seleccionados para el Premio Georg Waeber a la Innovación 2023 por la Förderkreis für die Mikroelektronik e.V. (Sociedad de Fomento de la Microelectrónica). La Förderkreis es una asociación de empresas industriales, dos institutos Fraunhofer, cuatro cátedras de la Universidad de Erlangen-Nuremberg y la Cámara de Comercio e Industria de Núremberg. Su principal objetivo es fomentar un intercambio fluido entre ciencia e industria, que se manifiesta en el Premio a la Innovación Georg Waeber. El premio se concede anualmente por logros científicos sobresalientes y hace especial hincapié en el avance de los conocimientos en microelectrónica y su aplicación práctica en la industria. El 25 de octubre de 2023, el Dr. Hippler, el Dr. Reimann y el Dr. Kranert recibieron el premio durante una ceremonia en el Fraunhofer IISB de Erlangen.
Preparando el camino para la próxima generación de electrónica de potencia de SiC
Los dispositivos semiconductores de SiC desempeñan un papel fundamental en la industria de la electrónica de potencia. Como sustituto de la electrónica de potencia convencional basada en silicio, el SiC tiene el potencial de mejorar la eficiencia energética y reducir los costes del sistema. Es relevante en diversas áreas de aplicación, desde la movilidad y el transporte eléctricos, el suministro de energía sostenible, las infraestructuras industriales hasta los sensores y las tecnologías cuánticas, incluso en condiciones de funcionamiento adversas. En consecuencia, el procesamiento de dispositivos de potencia de SiC de bajo coste, energéticamente eficientes y altamente fiables es una tarea crítica con la tendencia mundial a la electrificación. Las capacidades de producción de obleas de SiC experimentan un crecimiento significativo, que va de la mano de una creciente demanda de inspección y metrología de obleas dentro de la industria del SiC. En concreto, los fabricantes de sustratos y dispositivos de potencia necesitan información precisa sobre la calidad de los sustratos en términos de defectos cristalográficos, su distribución en toda la superficie de la oblea y las cantidades absolutas.
Nota: Este artículo ha sido traducido utilizando un sistema informático sin intervención humana. LUMITOS ofrece estas traducciones automáticas para presentar una gama más amplia de noticias de actualidad. Como este artículo ha sido traducido con traducción automática, es posible que contenga errores de vocabulario, sintaxis o gramática. El artículo original en Inglés se puede encontrar aquí.